集成电路失效分析步骤:
1. 开封前检查,外观检查,X光检查,扫描声学显微镜检查。
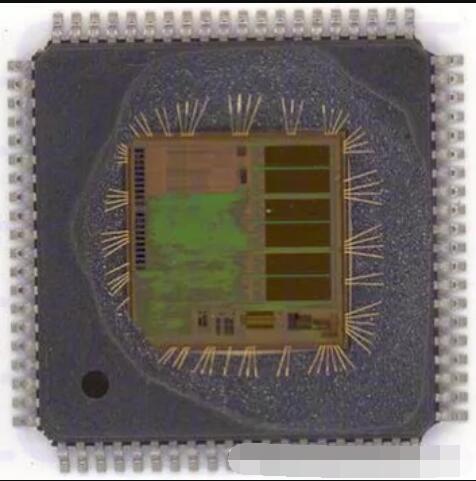
3. 电性能分析,缺陷定位技术、电路分析及微探针分析。
4. 物理分析,剥层、聚焦离子束(FIB),扫描电子显微镜(SEM),透射电子显微镜(SEM)、VC定位技术。
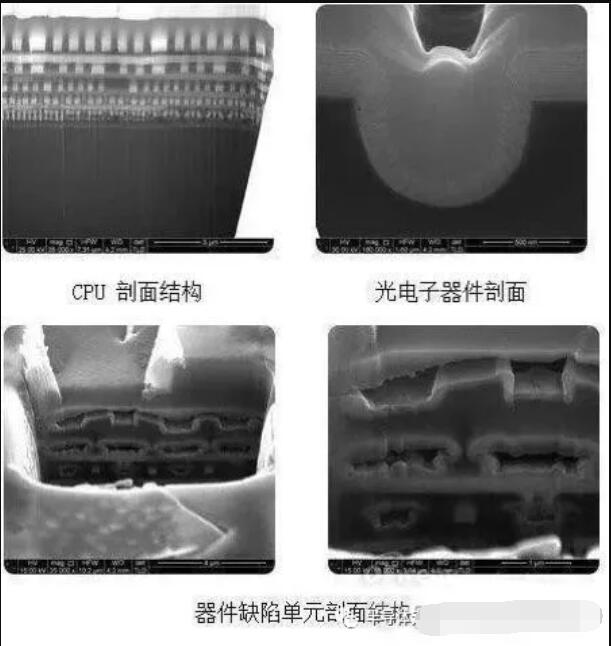
1.外观检查,主要凭借肉眼检查是否有明显缺陷,如塑脂封装是否开裂,芯片引脚是否接触良好。X射线检查是利用X射线的透视性能对被测样品进行X射线照射,样品缺陷部份会吸收X射线,导致X射线照射成像出现异常。X射线主要检查集成电路引线是否损坏问题。根据电子元器件的大小和结构选择合适的波长,这样能得到合适的分辨率。
2.扫描声学显微镜,是利用超声波探测样品内部缺陷,依据超声波的反射找出样品内部缺陷所在位置,这种方法主要用主集成电路塑封时水气或者高温对器件的损坏,这种损坏常为裂缝或者脱层。
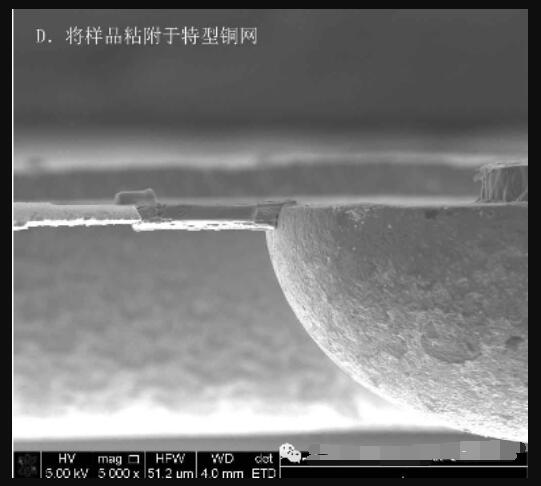
1. 打开封装,一般有三种方法。全剥离法,集成电路完全损坏,只留下完整的芯片内部电路。缺陷是由于内部电路和引线全部被破坏,无法再进行电动态分析 。方法二局总去除法,三研磨机研磨集成电路表面的树脂直到芯片。优点是开封过种不损坏内部电路和引线,开封后可以进行电动态分析。方法三是自自动法用硫酸喷射达到局部去除的效果。2.缺陷定位,定位具体失效位置在集成电路失效分析中,是一个重要而困难的项目,缺陷定位后才能发现失效机理及缺陷特征。a.Emission显微镜技术,具有非破坏性和快速精准的特性。它使用光电子探测器来检测产生光电效应的区域。由于在硅片上产生缺陷的部位,通常会发生不断增长的电子--空穴再结全而产生强烈的光子辐射。
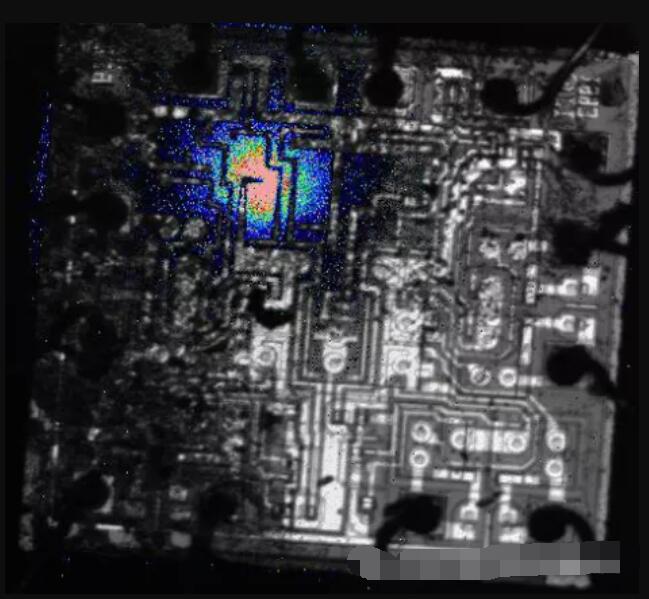
b. OBIRCH技术是利用激光束感应材料电阻率变化的测试技术。对不同材料经激光束扫描,可得到不同材料电阻率变化,这一方法可以测试金属布线内部的那些可靠性隐患。C.液晶热点检测一般由偏振显微镜,可调节温度的样品台,以及控制电路构成。在由晶体各向异性变为晶体各向同性时,所需要的临界温度能量很小,以此来提高灵敏度。同时相变温度应控制在30-90度,偏振显微镜要在正交偏振光的使用,这样可以提高液晶相变反应的灵敏度。
根据饰电路的版图和原理图,结合芯片失效现象,逐步缩小缺陷部位的电路范围,最后利用微探针显微技术,来定位缺陷器件。微探针检测技术,微探针的作用是测量内部器件上的电参数值,如工作点电压、电流、伏安特性曲线。微探针技术一般伴随电路分析配合使用,两者可以较快地搜寻失效器件。
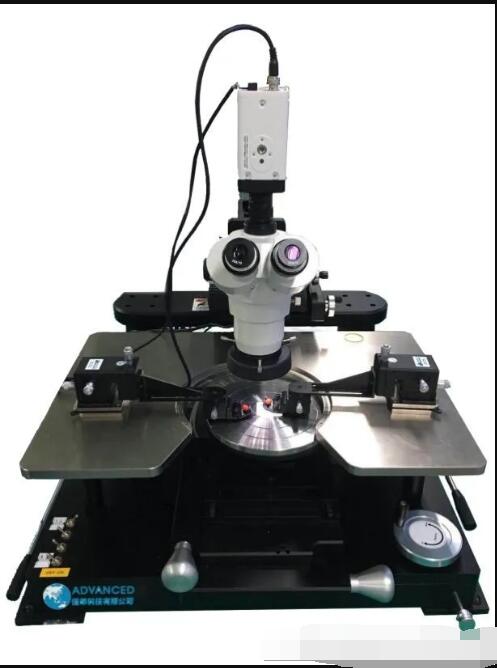
1. 聚焦离子束(FIB),由离子源,离子束聚焦和样品台组成。利用电镜将离子聚焦成微波尺寸的切割器。聚焦离子束的细微精准切割,结合扫描电镜的高分辨率成像,可以很好地解决剖面问题,定位精度可以达到0.1um以下,同时剖面过程过集成电路爱到的应力很小,完整地保存集成电路。2. 扫描电子显微镜(SEM),利用聚焦离子束轰击器件面表,面产生许多电子信号,将这些电子信号放大作为调制信号,连接显示器,可得到器件表面图像。透射电子显微镜(TEM),分辨率可以达到0.1nm,透射电子显微镜可以清晰地分析器件缺陷,更好地满足集成电器失效分析对检测工具的解析要求。
3. VC定位技术基于SEM或FIB的一次电子束或离子束,在样品表面进行扫描。硅片表面不现部位有不同电势,表现出来不同的明亮对比,找出导常亮的点从而定位失效点。